AI光通信不是向硅光演进,而是向PIC演进
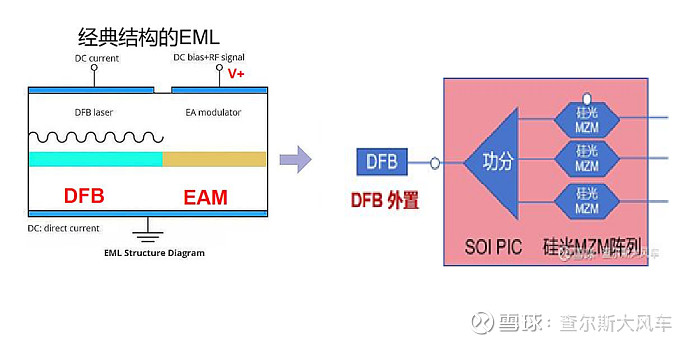
<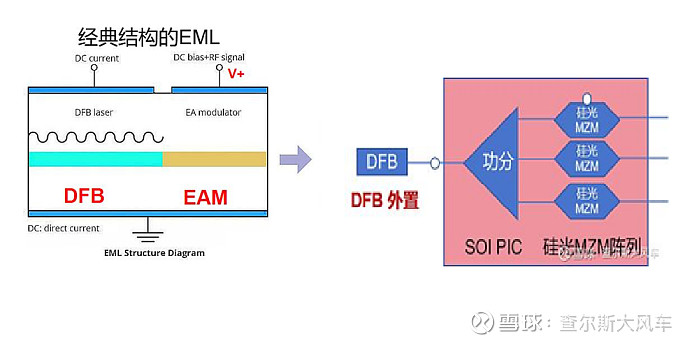
二、是封装变革,从“空间耦合”转向“固态波导”。
光模块60%以上加工成本消耗在精密封装,离散方案依赖精密对准,通道增加会使组装复杂度几何级提升。PIC将光路“刻蚀”在芯片内,把几十次精密空间对准转化为单次光纤阵列耦合,锁定生产良率,规避热胀冷缩或振动导致的光路失调,可靠性大幅提升。
同时由于集成度的提升,模块的尺寸整体变小,走线变小,也有利于高速场景下的高频信号质量。
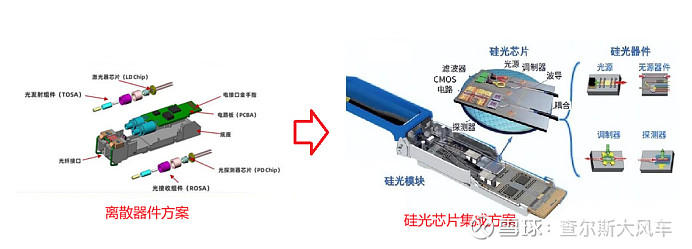
三、是制造工艺变革,实现晶圆级测试的规模效益
离散器件需封装完成后才能检测性能,失败则浪费封装材料与人工。PIC可在晶圆阶段用自动探针台筛查光电性能,切割封装前剔除不良品,类比集成电路生产模式,随产量爬坡实现单颗芯片成本指数级下降。
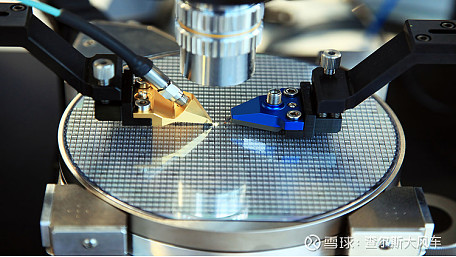
综上,PIC相较于传统离散器件模块,优势呈现为结构性跨代超越,所以在硅光PIC和EML 对比的时候,可制造性、功耗、成本等领先,EML只有性能领先。所以$中际旭创(SZ300308)$ 中际旭创、$新易盛(SZ300502)$ 新易盛等吃到了硅光的红利。
但是InP 也可以做PIC,InP PIC多路集成也能吃到上面三个方面的红利,$东山精密(SZ002384)$ 东山精密/索尔思的InP PIC就是一个例子:
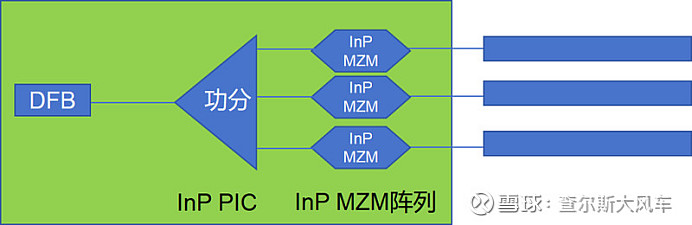
这种InP PIC的做法,同样可以极大的减少封装、耦合的成本。性能还非常好,获得了Lightwave 2026 LPO/LRO best in class 大奖。
当然这个InP PIC里面还有些高成本因素:
InP 的成本比较贵,做功分这种无源器件, MZM 自身尺寸问题等。成本高;所以InP MZM 在早期应该还是主要应用在价值高的场景:LPO@DR8、LRO@2xFR4 以及OCS场景。

但是InP PIC 自身还有很多低成本演进路径:
(1)6英寸晶圆;
(2)ER控制在4.5dB;
(3)DFB外置;
(4)功分器件使用低成本SiN 辅助等,只在最重要的调制器上使用InP 工艺。
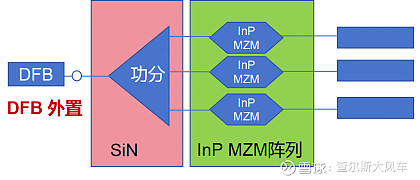
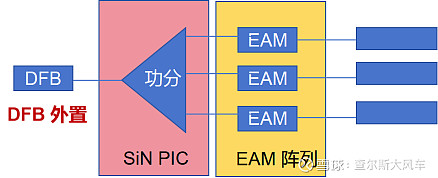
有人会问,良率如何控制,其实核心在于:把DFB进行了剥离后,MZM和EAM的良率都会有大幅的提升:
(1) MZM的良率控制在上篇文章已经提到:通过ER 4.5dB,带宽冗余等方式实现良率的大幅提升;
(2) EAM的良率控制思路也是类似的,主要少了DFB 的掣肘,没有DFB和EAM 的端面衔接问题,良率也会大幅提升;频宽没有了DFB 的电容耦合影响,频宽也容易突破110GHz。
(3) 从生产制造上,外延次数也会减少,成本也会有大幅的优化:
外延生产总结对比:

总结:
(1)通信技术是以性能为基础、成本、功耗等多维度约束的技术。
(2)随着速率的不断提升,客观上要求光模组小尺寸,高集成。硅光因为与CMOS兼容,天生容易做高集成;InP 平台因为晶圆成本和思维定式的原因,在100G时代没有拥抱PIC这个架构。
(3)而在200G 时代InP PIC 已经开发发力,索尔思的InP PIC 已经商用,性能、功耗相对于硅光和EML非常有优势,相信会有更多的公司会不断推出新架构的InP PIC产品,在高性能、高线性、OCS等场景发挥独特的优势。
简单总结一句话:
光通信的演进不是硅光,而是适合不同场景需求的更高集成度的PIC:硅光PIC、InP PIC、TFLN PIC
本话题在雪球有110条讨论,点击查看。
雪球是一个投资者的社交网络,聪明的投资者都在这里。
点击下载雪球手机客户端 http://xueqiu.com/xz]]>
#AI光通信不是向硅光演进而是向PIC演进





